談起半導體技術的發展,總是迴避不了「摩爾定律」這四個字——當價格不變時,集成電路上可容納的元器件的數目,約每隔18~24個月便會增加一倍,性能也將提升一倍。
芯片的製造工藝常常用XXnm來表示,比如Intel最新的六代酷睿系列CPU就採用Intel自家的14nm++製造工藝。所謂的XXnm指的是集成電路的MOSFET晶體管柵極的寬度,也被稱爲柵長。柵長越短,則可以在相同尺寸的硅片上集成更多的晶體管。
目前,業內最重要的代工企業臺積電、三星和GF(格羅方德),在半導體工藝的發展上越來越迅猛,10nm製程纔剛剛應用一年半,7nm製程便已經好似近在眼前,上個月雷鋒網剛剛還報道過下一代iPhone A12處理器將使用臺積電7nm製程生產的消息。
在業界盛行的摩爾定律將死的論調下,如此猛烈的突擊7nm製程需要克服怎樣的困難?幾方大佬又是如何佈局這一關鍵節點?雷鋒網將在本文爲您解讀。
半導體工藝的Tick-Tock
Tick-Tock,是Intel的芯片技術發展的戰略模式,在半導體工藝和核心架構這兩條道路上交替提升。半導體工藝領域也有類似的形式存在,在14nm/16nm節點之前,半導體工藝在相當長的歷史時期裏有着「整代」和「半代」的差別。
在戈登·摩爾提出著名的摩爾定律後,半導體產業一直堅持以18個月爲週期升級半導體工藝。直觀結果是,製程演進一直在以大約0.7的倍數逐級縮減,如1000nm->700nm->500nm->350nm->250nm等。
而在製程邁過180nm節點後,臺積電等代工廠提出了一種相比Intel的製程縮減0.9倍的工藝。這種工藝可以在不對產線進行大改的同時,提供1.24倍電路密度的芯片。Intel對此等技術非常不感冒,還爲其掛上了半代工藝的名號。
自此,Intel和IBM製造技術聯盟(包括三星和GF等)依然嚴格按着180nm->130nm->90nm->65nm->45nm->32nm->22nm的步調前行(三星和GF在32nm後轉向28nm),而臺積電等半導體晶圓代工廠則走上了150nm->110nm->80nm->55nm->40nm->28nm->20nm的路線。

製程演進
不過當半導體工藝繼續向前演進時,由於隨着晶體管尺寸逐漸縮小至接近物理極限,在各種物理定律的束縛下,半導體工廠如同戴着鐐銬跳舞,因此在幾家廠商紛紛出現「異常狀況」:本應屬於整代工藝的16nm製程被臺積電所用,Intel的14nm製程字面上卻應該屬於半代工藝的範疇。再接下來,幾家則不約而同的選擇了10nm->7nm->5nm的路線,整代和半代的區別自此成爲歷史。
也正是因爲這個原因,半導體廠商們進軍7nm製程的道路並不順利,還需要掀翻「光刻」、「晶體管架構」和「溝道材料」三座大山。
工欲善其事,先搞光刻機
作爲半導體工藝中最具代表性的,光刻技術可稱爲現代集成電路上最大的難題,沒有之一。
所謂光刻其實很好理解,就是讓光通過掩膜投射到塗抹了光刻膠的硅片上,將電路構造印在上面,類似於「投影描圖」,只是描圖的不是人手,而是機器,照射圖樣的也不再是可見光,而是紫外線。
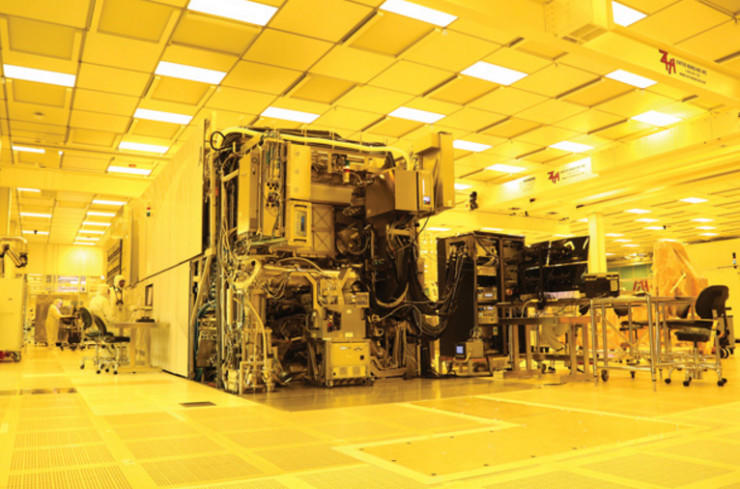
光刻車間
目前半導體生產中使用的是波長193nm的深紫外(DUV)光刻。實際上,在製程發展到130nm之前,人們就曾指出193nm深紫外光會發生嚴重的衍射現象而無法繼續使用,需要換用波長爲13.5nm的極紫外(EUV)光刻才能繼續縮小半導體工藝。
EUV的研發始於20世紀90年代,最早希望在90nm製程節點投入應用,然而EUV光刻機一直達不到正式生產的要求。無奈之下,人們只能通過沉浸式光刻、多重曝光等手段,將DUV一路推進到了10nm階段。
目前ASML的EUV光刻機使用40對蔡司鏡面構成光路,每個鏡面的反光率爲70%。這也就是說,EUV光束通過該系統中的每一對鏡面時都會減半,在經過40對鏡面反射後,只有不到2%的光線能投射到晶元上。
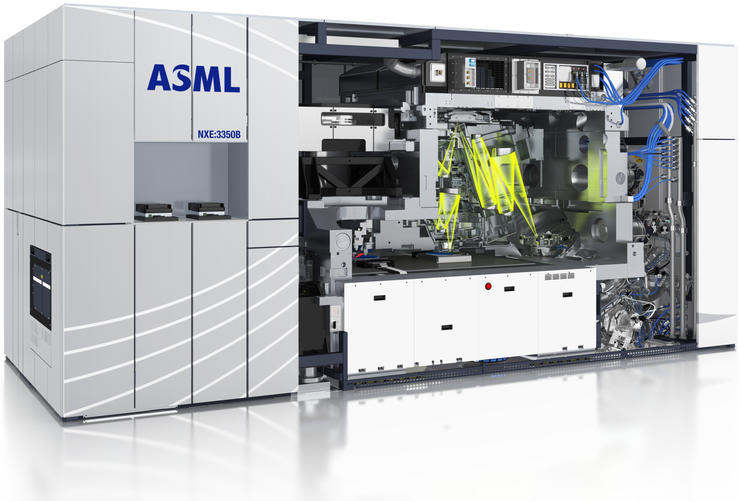
ASML光刻機光路示意
到達晶圓的光線越少,光刻所需的曝光時間就越長,相應的生產成本也就越高。爲了抵消鏡面反射過程中的光能損耗,EUV光源發出的光束必須足夠強,這樣才能與現在非常成熟的DUV光刻技術比拼時間成本。
但是多年以來,光照亮度的提升始終未能達到人們的預期,ASML的EUV產品市場負責人Hans Meiling曾表示,人們嚴重低估了EUV的難度。正在實驗中的EUV光源焦點功率剛剛達到250瓦,可以支撐機器每小時處理125個晶片,效率僅有現今DUV的一半。
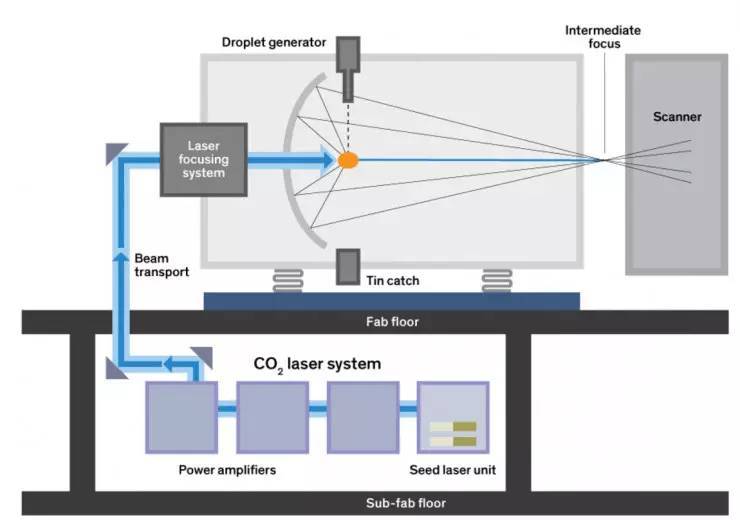
如果再加上價格和能耗,EUV取代DUV還會更加艱難。最新的EUV光刻機價格超過1億歐元,是DUV光刻機價格的二倍有餘,且使用EUV光刻機進行批量生產時會消耗1.5兆瓦的電力,遠超現有的DUV光刻機。
ASML方面表示,EUV光刻設備尚未徹底準備完成,最快也要到2019年才能應用於正式生產,因此幾大半導體代工廠均在DUV+多重曝光技術上繼續深挖,以求撐過EUV光刻機的真空期。
全新晶體管架構和溝道材料
通過DUV+多重曝光或EUV光刻縮小柵極寬度,進而刻畫出更小的晶體管,只是實現7nm的關鍵要素之一。隨着半導體工藝的發展,半導體溝道上的「門」會在尺寸進入亞原子級後變得極不穩定,這需要換用全新晶體管架構和溝道材料來解決。
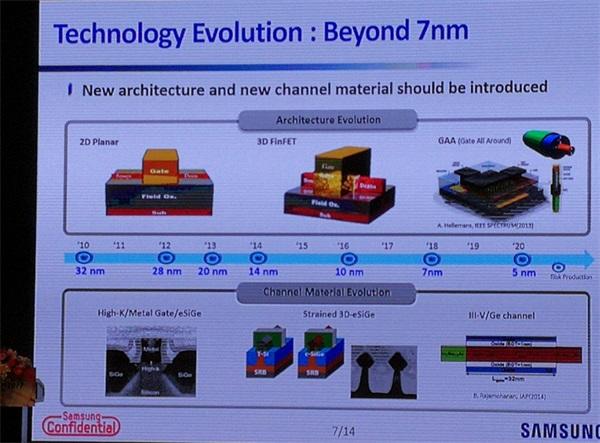
根據三星在CSTIC大會的報告,GAAFET(Gate All Around)是7nm製程節點上最好的選擇。GAAFET是一個周邊環繞着gate的FinFET,和目前垂直使用fin的FinFET不同,GAAFET的fin設計在旁邊,能夠提供比普通FinFET更好的電路特性。
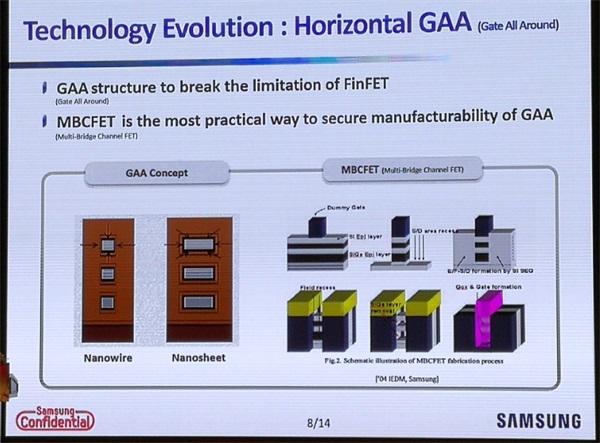
此外在進入7nm工藝時,半導體中連接PN結的溝道材料也必須要作改變。由於硅的電子遷移率爲1500c㎡/Vs,而鍺可達3900c㎡/Vs,同時硅器件的運行電壓是0.75~0.8V,而鍺器件僅爲0.5V,因而鍺在某一時期曾被認爲是MOSFET晶體管的首選材料,IBM實驗室的第一塊7nm芯片使用的就是Ge-Si材料。
IMEC(微電子研究中心)對新的摻鍺材料進行了研究,篩選出兩種可用於7nm的溝道材料:一種是由80%鍺組成的PFET,另一種是25%到50%混合鍺的FET或0到25%混合鍺的NFET。
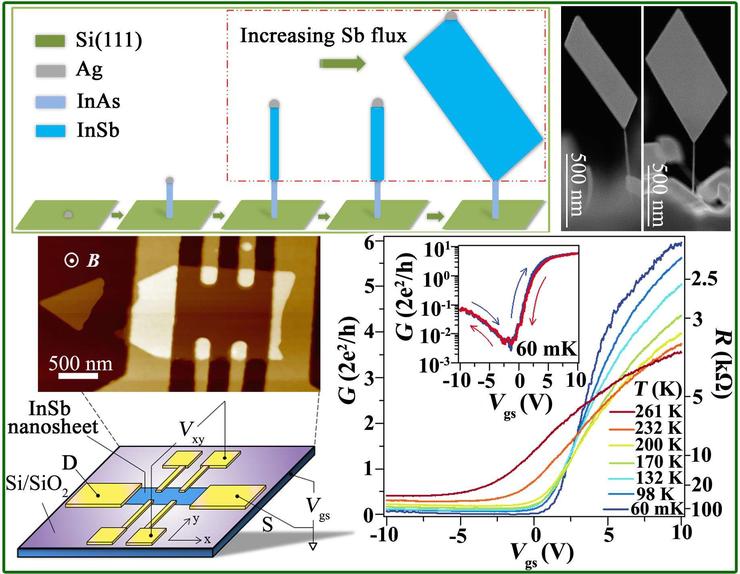
但是近來,III-V族材料開始受到廠商的更多關注。III-V族化合物半導體擁有更大的能隙和更高的電子遷移率,可以讓芯片承受更高的溫度並運行在更高的頻率上。且現有硅半導體工藝中的很多技術都可以應用到III-V族材料半導體上,因此III-V族材料也被視爲取代硅的理想材料。
7nm羣英會
瞭解了3大技術難題後,我們來看看幾大半導體代工廠分別如何部署7nm製程節點。
三星
作爲芯片代工行業的後來者,三星是「全球IBM製造技術聯盟」中激進派的代表,早早就宣佈了7nm時代將採用EUV。今年4月,三星剛剛宣佈已經完成了7nm新工藝的研發,併成功試產了7nm EUV晶元,比原進度提早了半年。
據日本PC WATCH網站上後藤弘茂的分析,三星7nm EUV的特徵尺寸爲44nm*36nm(Gate Pitch*Metal Pitch),僅爲10nm DUV工藝的一半左右。
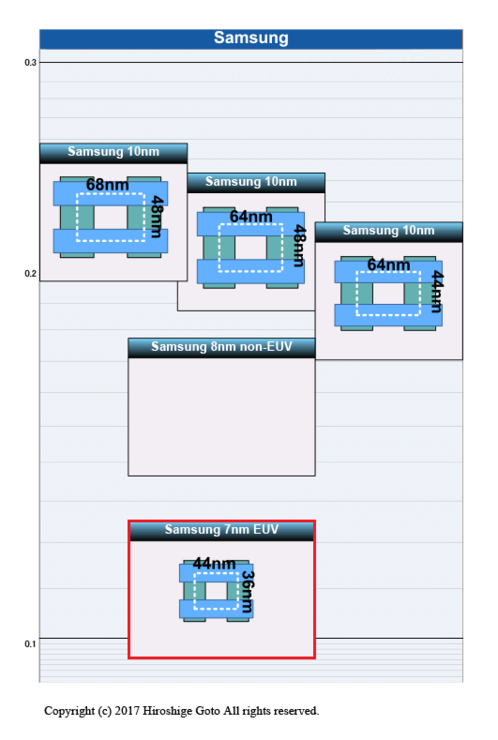
除了一步到位的7nm EUV外,三星還規劃了一種8nm製程。這個製程實際上是使用DUV光刻+多重曝光生產的7nm製程,繼承所有10nm工藝上的技術和特性。
由於DUV光刻的分辨率較差,因而芯片的電氣性能不如使用7nm EUV,所以三星爲其商業命名爲8nm。從這一點來看,8nm相比現有的10nm,很可能在晶體管密度、性能、功耗等方面做出了終極的優化,基本上可看做深紫外光刻下的技術極限了。

DUV和EUV光刻分辨率對比
此外,三星在7nm EUV之後,還規劃了使用第二代EUV光刻技術的6nm製程,它和8nm同樣是商業命名,屬於7nm EUV製程的加強版,電氣性能會更好。
根據三星的路線,三星將於今年下半年試產7nm EUV晶元,大規模投產時間爲2019年秋季。8nm製程大約在2019年第一季度登場,而6nm製程應該會在2020年後出現。
臺積電
相比三星直接引入EUV光刻的激進,臺積電在7nm上選擇了求穩路線,並沒有急於進入極紫外光刻時代。臺積電表示將繼續使用DUV光刻,利用沉浸式光刻和多重曝光等技術平滑進入7nm時代,然後再轉換到EUV光刻。
臺積電使用DUV光刻的第一代7nm FinFET已經在2017年第二季度進入試產階段。與目前的10nm FinFET製程相比,7nm FinFET將可在晶體管數量的情況下使芯片尺寸37%,或在電路複雜度相同的情況下降低40%的功耗。

在接下來的第二代7nm FinFET+製程上,臺積電將開始使用EUV光刻。針對EUV優化的佈線密度可帶來約10~20%的面積減少,或在電路複雜度相同的情況下,相比7nm FinFET再降低10%的功耗。
而根據後藤弘茂的分析,臺積電7nm DUV的特徵尺寸介於臺積電10nm FinFET和三星7nm EUV之間,Metal Pitch特徵尺寸40nm,Gate Pitch特徵尺寸尚不明確,但必定小於10nm時的66nm。
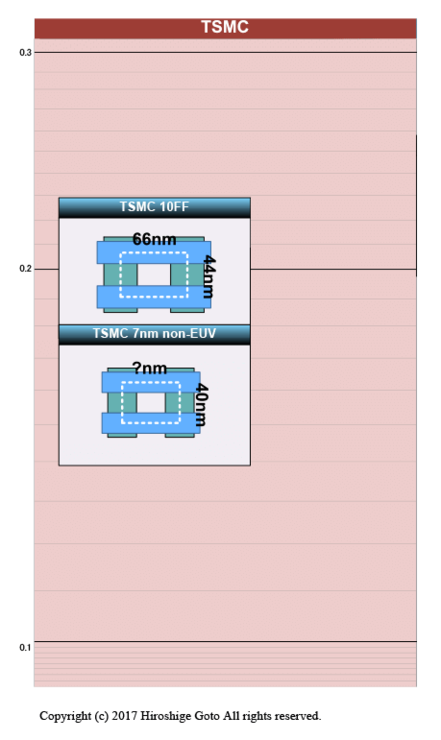
此外,與完全使用DUV工具製造的芯片相比,使用EUV光刻生產芯片的週期也將縮短,臺積電計劃在2018年第二季度開始試產7nm FinFET+晶元。
GF
GF此前曾是AMD自家的半導體工廠,後由於AMD資金問題而拆分獨立。GF同樣屬於IBM「全球IBM製造技術聯盟」的一員,其半導體工藝和三星同宗同源。然而GF在28nm、14nm兩個節點上都遇到了重大技術難題,不得不向「後來者」三星購買生產技術。
介於此,GF在14nm之後決定放棄10nm節點,直接向7nm製程進軍。雖然這個決策稍顯激進,但GF也明白步子大了容易扯到啥的道理,決定在光刻技術上穩中求進,使用現有的DUV光刻技術實現第一代7nm工藝的製造,隨後再使用EUV光刻進行兩次升級迭代。
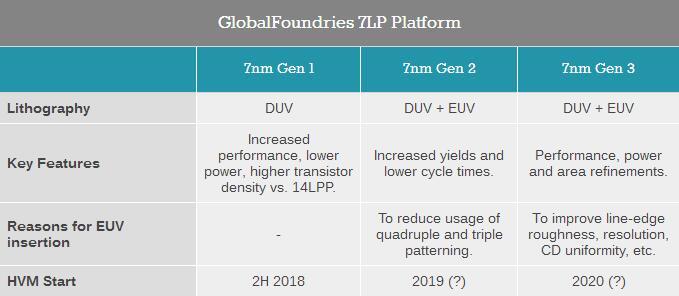
雷鋒網(公衆號:雷鋒網)在去年7月曾報道過GF名爲7LP的7nm DUV製程細節,據其在阿爾伯尼紐約州立大學理工學院負責評估多重光刻技術的George Gomba以及其他IBM的同事透露,GF將在第一代7nm DUV產品上,使用四重光刻法。
相比之前的14nm LPP製程,7LP製程在功率和晶體管數量相同的前提下,可以帶來40%的效率提升,或者在頻率和複雜性相同的情況下,將功耗降低60%。但受限於四重光刻這一複雜流程,GF表示根據不同應用場景,7LP只能將芯片功耗降低30~45%。
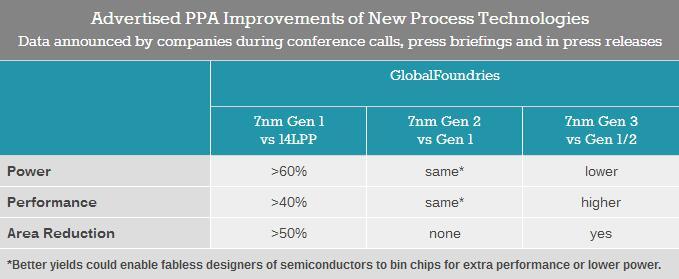
從後藤弘茂分析中可以看到,GF的7nm DUV特徵尺寸爲56nm*40nm(Gate Pitch*Metal Pitch),應當與臺積電7nm DUV的基本相當。而7nm EUV的特徵尺寸爲44nm*36nm,與三星7nm EUV完全一致(畢竟同源)。
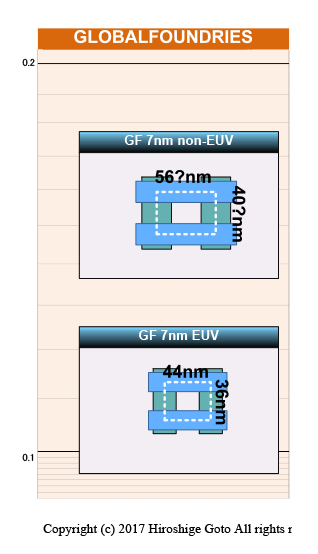
不過在EUV的部署上,GF尚存在一些阻礙。據雷鋒網瞭解,目前ASML提供的保護膜僅適用於每小時85個晶片的生產率(WpH),而GF今年的計劃是達到125WpH,這意味着現有的保護膜無法應對量產所需的強大光源。
目前,GF尚未透露將於何時開始使用EUV光刻,只說要等到「準備就緒」以後,不過看起來難以在2018年以前準備就緒。因此業界普遍猜測GF最早也要到2019年才能使用EUV光刻生產芯片。
Intel:我不是針對誰……
Intel作爲全球最大的半導體企業,在半導體工藝方面一直保持着領先地位,並且引領了大量全新技術的發展。不過近幾年,Intel半導體工藝的發展速度似乎逐漸慢了下來,比如14nm工藝竟然用了三代,10nm工藝也被競爭對手搶先。
實際上,三星和臺積電在進入16/14nm節點後,在製程上常使用一些商業命名,比如上面提到的三星7nm製程,優化一下就變成了6nm。而Intel的14nm製程雖然歷經兩次優化,卻只是以14nm、14nm+和14nm++來命名,二者已經不存在直接的可比性。
由於晶體管制造的複雜性,每代晶體管工藝中有面向不同用途的製造技術版本,不同廠商的代次之間統計算法也完全不同,單純用代次來對比是不準確的。目前業內常用晶體管密度來衡量制程水平,實際上,Intel最新10nm製程的晶體管密度甚至反而要比三星、臺積電的7nm製程更高。
根據Intel公佈的晶體管密度表格,其45nm製程的晶體管密度約爲3.3MTr/mm²(百萬晶體管每平方毫米),32nm爲7.5MTr/mm²,22nm爲15.3MTr/mm²,上升倍數大約爲2.1倍。但是14nm時晶體管密度大幅提升了2.5倍,爲37.5MTr/mm²,10nm更是比14nm提升了2.7倍之多,達到100.8MTr/mm²。

而根據後藤弘茂的分析,如果將Intel、臺積電、三星和GF近些年製程的特徵尺寸放在一起對比,也可以看出Intel的14nm製程確實要優於三星和GF的14nm LPP以及臺積電的16nm FinFET,僅略輸於三星早期的10nm製程。
Intel的10nm製程則更是全面勝過臺積電和三星的10nm製程,甚至比臺積電和GF的第一批7nm DUV都要更好。雖然不如三星和GF的第二批7nm EUV製程,但Intel肯定也會深挖10nm製程,第二代10nm趕超三星和GF的7nm EUV也不是不可能。

國外網站Semiwiki日前也討論到了三星的10nm、8nm以及7nm製程的情況,其中10nm製程的晶體管密度是55.5MTr/mm²,8mm是64.4MTr/mm²,7nm也不過101.23MTr/mm²,堪堪超過Intel 10nm製程一點點。
下一站,5nm
從眼下7nm製程的種種困難可以看出,在5nm及以後的節點上,晶體管的結構很有可能仍然需要進行改進,目前比較受關注的是一種類似羅漢塔式的Nanosheet晶體管。
Nanosheet是「IBM聯盟」在2017年6月的Symposia on VLSI Technology and Circuits半導體會議上提出的,其晶體管爲「將FinFET 90度放倒」的扁平堆棧化結構。
雷鋒網在查看了後藤弘茂的分析後粗略得知,IBM聯盟展示了沿着從源級(source)到漏級(drain)方向90度切開的晶體管橫截面,可以看到FinFET工藝上Channel是直立的,就如同鰭片的造型,將這些鰭片90度放到後,就變成了Nanowire的形狀。

有趣的是,本來FinFET就是將原來的Planer型晶體管90度「放倒」而成。Planer型晶體管是在平面內生成,在其上面緊接着生成柵極(gate)。
而FinFET將平面的Channel給90度立了起來,這樣變成三個方向都有柵極的三重門(Tri-gate)電路。Channel基本上脫離了硅基板,不僅抑制了電子遷移,而且增加了柵極的長度。

而與FinFET的三面柵極不同,Nanosheet是4面360度全包,可以進一步抑制電子遷移,提高柵極長度,加強電子驅動能力。如果都是三鰭片結構,Nanosheet柵極長度是FinFET的1.3倍。
Nanosheet在良品率方面也比FinFET更有優勢。垂直Channel的FinFET更依靠曝光技術,而水平Channel的Nanosheet更依靠薄膜生成技術。根據實驗室的說法,垂直加工比水平加工在半導體制程上更加困難。
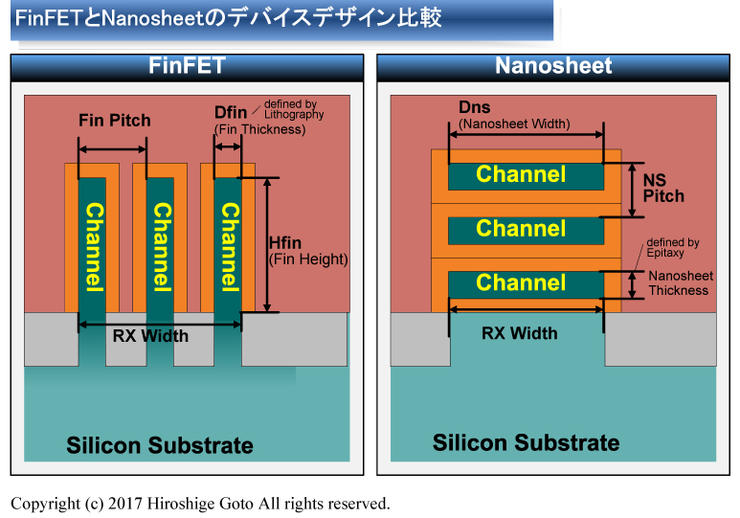
但是正如7nm有三座大山一樣,5nm製程要解決的也不只有晶體管架構,還有全新佈線層材料等難點的存在。根據幾家半導體廠商的roadmap,5nm製程被暫定在2020年上馬,至少Nanosheet是以此爲目標的。
硅半導體的夕陽紅
如同過去一樣,摩爾定律的命運不僅取決於芯片工藝的尺寸,也取決於物理學家和工程師,對生產出的晶體管和電路可以改善到何種程度。三星、臺積電和GF的技術進步,讓我們看到了7nm製程時代的發展方向。即便需要克服大量物理與工程難題,集成電路產業也在一步一步向前走。
不過當未來半導體工藝進一步發展到5nm甚至3nm後,電路中最窄的地方甚至只有十幾個原子的厚度,屆時硅半導體工藝可能真的要面臨極限,如今幾方競相角逐7nm製程的情景完全可以說是硅半導體的夕陽紅。
在這樣的情況下,我們希望這些半導體企業攜起手來,在未來的半導體產業上繼續努力,繼續遵循着摩爾定律的腳步,將人類的計算能力和製造能力推向一個全新的高峯。
相關文章:
深度 | 半導體巨頭押注的 EUV 光刻,真能拯救摩爾定律嗎?(下)
